高阶载板FCBGA+玻璃Core
高阶载板FCBGA:高性能芯片封装的核心技术
FCBGA(Flip Chip Ball Grid Array) 是一种以倒装焊(Flip Chip)技术结合球栅阵列(BGA)封装的高端集成电路封装形式。而高阶载板(High-Density Substrate)作为其核心载体,通过精细化线路设计和多层堆叠结构,支撑着现代高性能芯片(如CPU、GPU、AI加速器)的复杂互连与高效散热需求。
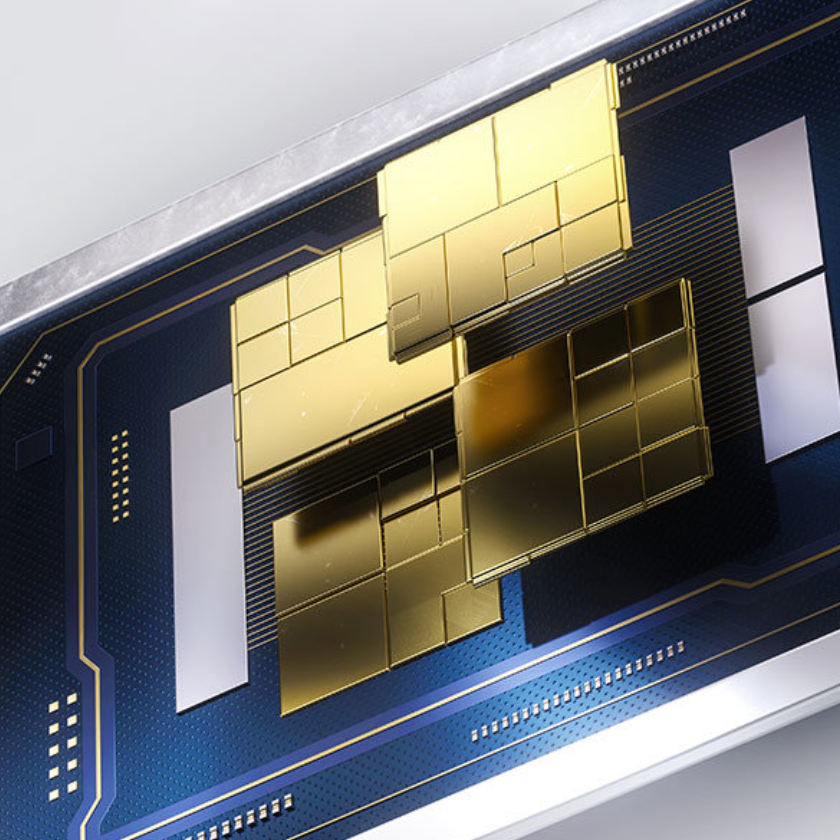
核心特点
- 高密度互连(HDI)
- 载板采用微米级线路(线宽/线距 ≤ 10μm)和积层工艺(Build-Up Layer),实现超高I/O密度(数千至数万引脚),满足大型芯片的互连需求。
- 支持多阶盲埋孔、电镀填孔等技术,提升信号传输效率。
- 倒装焊技术
- 芯片正面朝下直接焊接至载板,通过微凸块(Microbump) 实现短距离电性连接,减少信号延迟,提升电气性能。
- 优异散热与可靠性
- 载板集成金属散热层或嵌入式铜柱,配合外部金属顶盖(Heat Spreader),高效导出芯片热量。
- 使用低热膨胀系数(CTE)材料(如ABF、BT树脂或新型玻璃芯),减少热应力导致的翘曲失效。
典型应用场景
- 高性能计算:服务器CPU/GPU、AI加速芯片(NVIDIA H100, AMD MI300)。
- 先进封装:2.5D/3D IC(如CoWoS、EMIB技术中的基础载板)。
- 通信与网络:5G/6G基站芯片、高速交换器。
- 高端消费电子:游戏主机SoC、旗舰手机处理器。
技术演进方向
- 材料升级:从传统有机基板(ABF)向玻璃基板(Glass Core) 过渡,解决超大尺寸封装翘曲问题。
- 结构创新:嵌入硅桥、无源器件,实现“子系统级”集成。
- 工艺精进:激光钻孔、半加成法(mSAP)推动线宽进一步微缩至5μm以下
高阶载板FCBGA + 玻璃芯材(Glass Core):引领先进封装的新材料革命
在追求更高性能、更小尺寸和更高集成度的半导体封装趋势下,高阶载板(High-Density Interconnect Substrate)已成为关键组件。而玻璃芯材(Glass Core)正作为一种革命性的基础材料,取代传统的有机芯材(如BT树脂、ABF等),用于制造下一代高阶载板。
相较于有机材料,玻璃芯材具有显著优势:
- 极致平整度与稳定性: 玻璃表面极其平整且热膨胀系数(CTE)极低,能完美匹配硅芯片,显著减少翘曲,提升制造良率,尤其适用于超大尺寸封装。
- 卓越的高频性能: 玻璃作为绝缘体,具有超低且稳定的介电常数(Dk)和损耗因子(Df),非常适合高速(如56Gbps及以上)和毫米波应用,信号传输损耗小、完整性高。
- 超高布线密度: 其刚性和稳定性支持更精细的线路(微米级线宽/线距)和微孔(<10μm),实现前所未有的互连密度,满足HPC、AI芯片等对极高I/O数和带宽的需求。
- 优异的热稳定性: 玻璃耐高温,热变形小,能承受先进封装工艺(如热压键合)和芯片运行产生的高温,长期可靠性更佳。
应用前景
玻璃芯高阶载板被视为实现下一代先进封装技术(如CoWoS-L, HBM3/4集成, 2.5D/3D IC) 的关键赋能者,尤其适用于高性能计算(HPC)、人工智能(AI)、数据中心、5G/6G通信和高端移动设备等领域,为突破摩尔定律限制提供强大支撑。
伊乐电子提供的设备方案

深圳市伊乐电子有限公司
深圳市龙岗区宝龙街道同心社区长湖围工业区9号S7栋101
华南地区联系方式:Yvette 13410131178
华东地区联系方式:Robert 13424322768

