晶圆级先进封装FOWLP
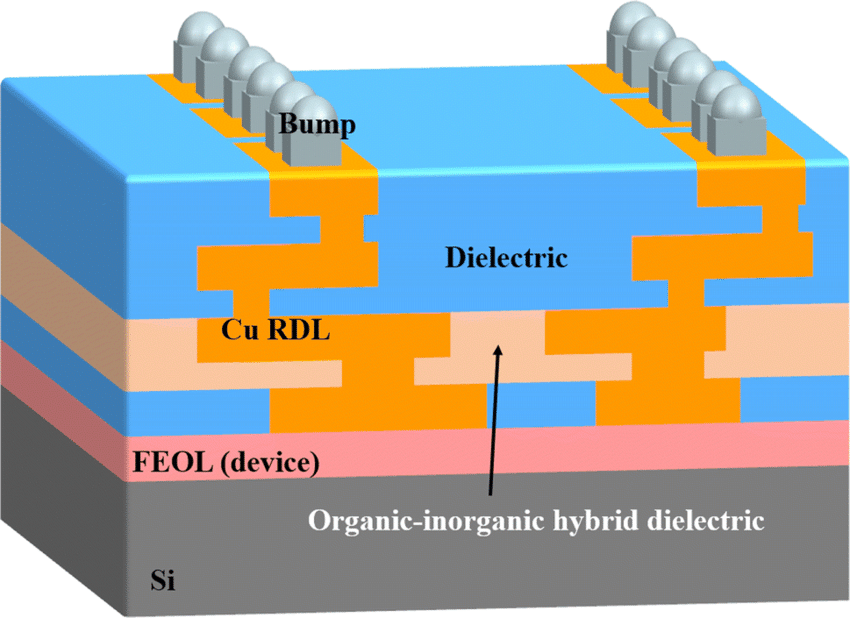
晶圆级先进封装(FOWLP) 是一种创新的半导体封装技术。其核心在于将传统后道封装工艺(如贴装、互连、成型)直接转移到整片晶圆上进行,而不是对单个切割好的芯片(Die)逐个处理。FOWLP 最显著的特点是“扇出”(Fan-Out),它允许芯片的输入/输出(I/O)触点通过重新布线层(RDL)扩展到芯片自身的物理尺寸之外。这种技术省去了传统封装中的基板和引线键合,显著减小了封装尺寸和厚度,提升了电性能和散热效率,同时降低了成本。FOWLP 尤其适用于对尺寸、性能和集成度要求极高的应用,如智能手机、物联网设备、高性能计算和人工智能芯片,是推动半导体持续微型化和高性能化发展的关键技术之一。
晶圆级先进封装FOWLP-主要工艺及设备方案
晶圆级扇出型封装(FOWLP) 是一种在整片晶圆上完成核心封装步骤的先进技术,其核心工艺区别于传统单颗芯片封装。主要流程包括:
- 晶圆重构:
- 芯片获取与放置: 将测试合格的已知良好芯片(KGD)从供体晶圆上取下,并精确地放置到带有临时键合胶的载板(Carrier) 上,形成新的布局阵列。
- 模塑封装:
- 压缩模塑: 使用环氧树脂模塑料(EMC)覆盖芯片和载板,在高温高压下成型固化,形成一个包含所有芯片的重构晶圆(Reconstituted Wafer)。此步骤提供结构支撑和保护。
- 载板移除与表面处理:
- 移除临时载板,对模塑后晶圆表面进行研磨和平坦化处理,暴露出芯片的焊盘。
- 重新布线层(RDL)构建:
- 核心“扇出”工艺: 在平坦化的晶圆表面,通过光刻、镀铜、蚀刻等半导体工艺,沉积一层或多层精细的铜布线(RDL)。这些布线层将芯片自身的焊盘扇出(Fan-Out) 到芯片物理边界之外的区域,形成外部连接点。这是实现高密度互连和小型化的关键。
- 凸点下金属化(UBM)与植球:
- 在RDL的扇出焊盘上制作UBM层,然后植上锡球,作为最终与电路板连接的电接口。
- 切割:
- 将完成所有工艺的整片重构晶圆切割成单个的封装体。
伊乐电子提供的设备方案

深圳市伊乐电子有限公司
深圳市龙岗区宝龙街道同心社区长湖围工业区9号S7栋101
华南地区联系方式:Yvette 13410131178
华东地区联系方式:Robert 13424322768

