板级先进封装FOPLP
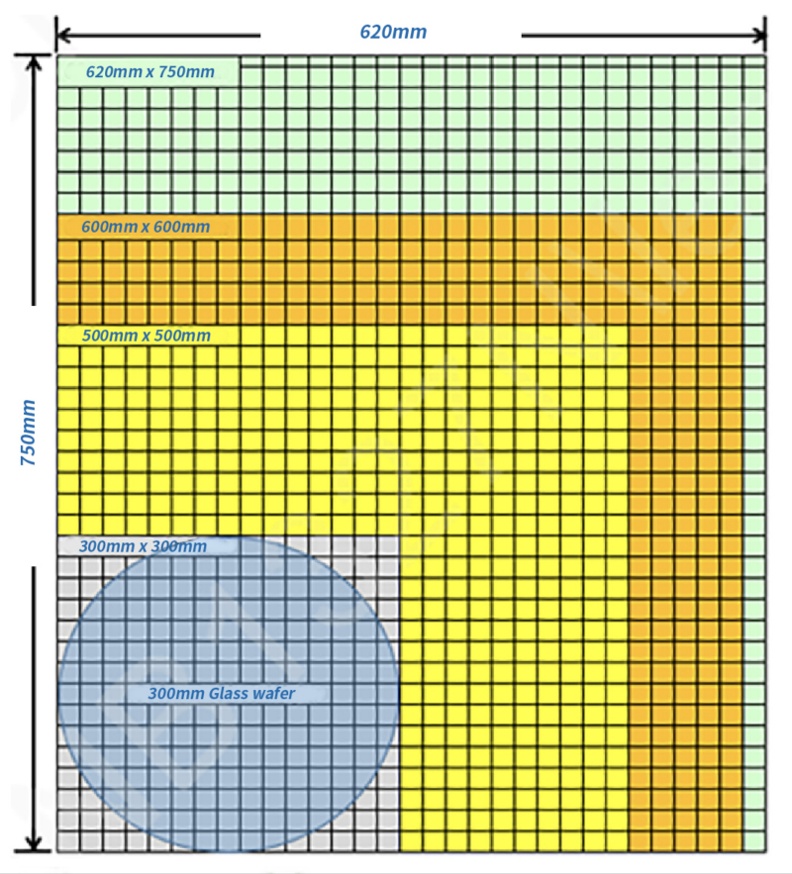
板级先进封装(FOPLP, Fan-Out Panel Level Packaging) 是扇出型封装技术的重要延伸与创新。其核心理念借鉴了晶圆级扇出封装(FOWLP),但将加工载体从圆形硅晶圆升级为更大的矩形面板(Panel)(通常面积大于500mm²,远大于300mm晶圆)。FOPLP直接在面板上对多个芯片进行高密度布局、模塑料(EMC)封装成型、构建高精细度的重新布线层(RDL)以实现“扇出”互连,最后切割成单个封装体。
FOPLP的核心优势在于利用更大的面板尺寸实现更高的生产效率和显著的成本降低潜力,尤其适合需要大规模量产的消费电子、物联网、汽车电子等中高端芯片封装。它被视为突破传统晶圆尺寸限制、推动扇出封装进一步降本普及的关键技术方向,但也面临着面板均匀性控制、高精度对位等制造挑战。
板级先进封装FOPLP-主要工艺及设备方案
- 载板准备与芯片贴装
- 面板载体制备:采用矩形面板(尺寸通常为 510mm × 515mm 或更大,面积≈4倍300mm晶圆)作为载体,材质可为 玻璃/金属层压板/PCB,表面涂覆临时键合胶。
- 高精度芯片贴装:将 已知良好芯片(KGD) 通过高速取放设备(精度≤10μm)精确贴装到面板上,布局密度显著高于晶圆级(FOWLP)。
- 面板级模塑封装
- 压缩成型(Compression Molding):用 环氧模塑料(EMC) 覆盖整个面板,在高温高压(>180°C, >5MPa)下固化,形成 重构面板(Reconstituted Panel)。
- 载板分离与表面处理
- 临时键合胶去除:通过激光或化学方法剥离载板,暴露芯片焊盘。
- 表面研磨:对面板进行机械/化学研磨,实现 全局平坦化(TIV≤5μm),确保后续布线精度。
- 面板级重新布线(RDL)
- 溅射沉积种子层:做Plasma Descum后溅射Ti+Cu作为种子层,为后续电镀铜布线提供导电基底。
- 光刻图形化:涂光刻胶 → 曝光显影 → 定义RDL图形。
- 电镀铜增厚:电镀铜填充图形,形成互连线路。
- 去胶与刻蚀种子层:去除光刻胶 → 湿法刻蚀移除暴露区域的铜/钛种子层(保留布线下的种子金属)。
- 凸点制备与切割
- 植球(Solder Ball Placement):在RDL焊盘上制作 UBM(凸点下金属化)层,植入锡球。
- 面板切割(Singulation):用 激光切割/刀片切割 将大面板分割为单个封装体,需避免边缘崩裂(EMC与芯片硬度差异)。
伊乐电子提供的设备方案

深圳市伊乐电子有限公司
深圳市龙岗区宝龙街道同心社区长湖围工业区9号S7栋101
华南地区联系方式:Yvette 13410131178
华东地区联系方式:Robert 13424322768

